當(dāng)前位置: [科普] 增強(qiáng)型HEMT器件介紹
隨著電力轉(zhuǎn)換系統(tǒng)功率密度和工作頻率的不斷提高 ,需要開發(fā)性能優(yōu)于傳統(tǒng)半導(dǎo)體的功率器件�。氮化鎵(GaN)作為第三代半導(dǎo)體材料的典型代表 ,被認(rèn)為是提高大功率電力系統(tǒng)轉(zhuǎn)換效率的新一代功率器件的主要候選材料�。在操作類型方面 ,增強(qiáng)型(也稱為常關(guān)型)器件具有安全 �����、能簡(jiǎn)化電路設(shè)計(jì)以及更優(yōu)的電路拓?fù)湓O(shè)計(jì)等優(yōu)勢(shì) �����,在行業(yè)應(yīng)用中更具吸引力���。本文簡(jiǎn)單介紹下增強(qiáng)型HEMT����。目前 ,在第三代半導(dǎo)體材料中 ,氮化鎵( GaN) 和碳化硅( SiC) 的發(fā)展較為成熟 ,且材料本身具有大的臨界擊穿電場(chǎng) ��、耐高溫和抗輻照等特點(diǎn) ,所以更適合制作電力電子器件��。 目前�����,SiC在高壓(高于1200 V) 市場(chǎng)占據(jù)明顯優(yōu)勢(shì) ,但在功率轉(zhuǎn)換和高頻工作方面,GaN具有更加明顯的優(yōu)勢(shì) ����。GaN 轉(zhuǎn)換器的低損耗歸因于其低的開關(guān)損耗 ,這是由于GaN相比于SiC 具有更好的電子傳輸能力。沿Ga面方向外延生長(zhǎng)的結(jié)構(gòu)存在較強(qiáng)的自發(fā)極化和壓電極化效應(yīng) ,這會(huì)導(dǎo)致GaN材料的異質(zhì)結(jié)結(jié)構(gòu)(典型如AlGaN/GaN) 界面處產(chǎn)生高濃度的二維電子氣(2DEG),因此 GaN 器件具有更低的導(dǎo)通電阻����。在相同耐壓等級(jí)下 ,GaN 材料更適合制 作高效的電力電子器件 ,特別是橫向結(jié)構(gòu)的高電子遷 移率晶體管(HEMT),其導(dǎo)通電阻比 Si 器件的導(dǎo)通電 阻低 1~2個(gè)數(shù)量級(jí) ,與同為第三代半導(dǎo)體材料的 SiC 器件相比 ,其導(dǎo)通電阻減小1/2~ 1/3。從器件結(jié)構(gòu)看,GaN器件分為縱向和橫向結(jié)構(gòu) ��。縱向結(jié)構(gòu)的器件需要用到 GaN自支撐襯底 ,而目前來看 ,GaN自支撐外延片的成本較高,且GaN自支撐襯底的外延片尺寸較小,這就使得單個(gè)器件的成本更高 ����。橫向器件從開關(guān)類型看 ,分為耗盡型(常開型 ,D-mode) 和增強(qiáng)型(常關(guān)型 ,E-mode) 器件。由于AlGaN/GaN 界面會(huì)產(chǎn)生高電子濃度(約 1013 cm -2 .eV -1)、高 遷移率 [ 約2000 cm2/( V .s) ]的2DEG ,傳統(tǒng)的 GaN HEMT是耗盡型的 ,即器件柵極在 零偏壓下溝道中仍然存在高濃度的 2DEG ,使器件處于開啟狀態(tài) �。而增強(qiáng)型器件在柵極零偏壓時(shí)可以耗盡 柵下溝道中的 2DEG ,使器件處于關(guān)斷狀態(tài)。增強(qiáng)型器 件也因此具有安全����、節(jié)能和能簡(jiǎn)化電路設(shè)計(jì)等方面的 優(yōu)勢(shì) ,是未來功率器件的重要發(fā)展方向。從市場(chǎng)應(yīng)用角度來看 ,以耐受電壓 600~ 1200 V 為 界 ,低于 600 V 的市場(chǎng)以 GaN 為主 ,主要面向消費(fèi)類電子領(lǐng)域 ,這是目前 GaN 材料切入市場(chǎng)的最主要突破口 ���。600~ 1200 V 這一區(qū)間是 GaN 與 SiC 共存的領(lǐng)域 , 其主要應(yīng)用在電動(dòng)汽車( EV) 與混合動(dòng)力汽車( HEV)的轉(zhuǎn)換器以及可再生能源的逆變器中�。高于1200 V 的市場(chǎng)以 SiC 為主 ,未來GaN 材料的晶體質(zhì)量若能進(jìn)一 步提高,體材料的缺陷密度進(jìn)一步減小,或縱向結(jié)構(gòu)的GaN 器件技術(shù)成熟度提高 ,其也會(huì)在高電壓市場(chǎng)中展現(xiàn)出更強(qiáng)大的競(jìng)爭(zhēng)力 ��。從基礎(chǔ)科研到產(chǎn)業(yè)化 ,有若干個(gè)重要指標(biāo)可以評(píng)估 GaN 增強(qiáng)型 HEMT器件的性能 ,典型的有擊穿電壓 VB�����、閾值電壓 Vth�、開態(tài)電阻Ron、飽和電流密度IDS�、柵耐壓、閾值電壓滯回等 ��。本文回顧了一系列增強(qiáng)型器件的實(shí)現(xiàn)方案 ,著重介紹了基于柵凹槽結(jié)構(gòu)的功率器件技術(shù)方案以及若干重要工藝 ,并提出了未來可能的技術(shù)方案����。由于耗盡型 HEMT 器件的柵極無需復(fù)雜的特殊加工工藝,所以器件技術(shù)成熟較早,隨著制作工藝的不斷完善���;器件的導(dǎo)通電流、擊穿電壓�����、特征電阻等關(guān)鍵參數(shù)已經(jīng)取得較為理想的結(jié)果�����。GaN D-mode HEMT 器件結(jié)構(gòu)耗盡型 GaN HEMT 在產(chǎn)業(yè)界面臨的可靠性問題主要有電流崩塌�����、硬開關(guān)模式下閾值電壓的漂移等����, 這些可靠性問題與場(chǎng)板的設(shè)計(jì)、柵介質(zhì)層的選擇����、GaN 緩沖層的設(shè)計(jì)和鈍化層材料的選擇等有關(guān)。需要對(duì)器件的制作工藝細(xì)節(jié)進(jìn)一步優(yōu)化,以提高器件的可靠性���。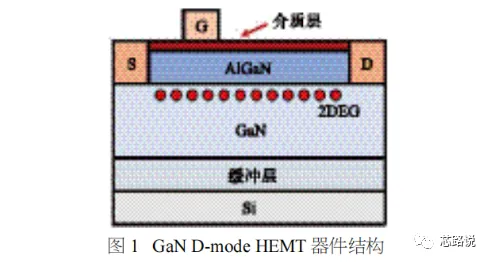
實(shí)現(xiàn)增強(qiáng)型 GaN HEMT 器件操作的方法有幾種�,主要是基于耗盡/減弱 AlGaN/GaN 異質(zhì)結(jié)界面處的極化電荷來實(shí)現(xiàn)的��。幾種實(shí)現(xiàn)增強(qiáng)型操作的主流方案包括凹柵結(jié)構(gòu)��、氟化柵結(jié)構(gòu)和 p-GaN 插入層結(jié)構(gòu)�。除此之外,共源共柵級(jí)聯(lián) cascode結(jié)構(gòu)���、薄勢(shì)壘結(jié)構(gòu) UTB和縱向短溝道結(jié)構(gòu) VG-HEMT也可以實(shí)現(xiàn)器件的增強(qiáng)型操作�。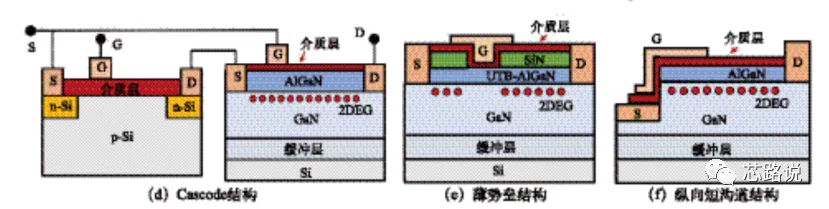
柵區(qū)勢(shì)壘層的刻蝕往往會(huì)引入界面態(tài)���,對(duì)器件性能造成不良影響�����,同時(shí)刻蝕精度的控制也會(huì)影響器件 的閾值電壓和導(dǎo)通電阻�。凹柵結(jié)構(gòu)一般都會(huì)使用金屬-絕緣體-半導(dǎo)體(MIS)/金屬-氧化物-半導(dǎo)體(MOS)結(jié)構(gòu)這能夠使器件柵極具有更大的安全工作范圍和更低的泄漏電流��。然而 MIS/MOS 結(jié)構(gòu)的器件閾值電壓的穩(wěn)定性較差���,這主要是由介質(zhì)層/半導(dǎo)體界面的電荷和陷阱引起的���,有報(bào)道稱在氧化物/三族氮化物界面處的界面陷阱密度 Dit 較高����,這會(huì)導(dǎo)致柵泄漏電流的增加和閾值電壓的不穩(wěn)定���。因此,為追求高性能的 GaN HEMT 器件�,柵槽的界面態(tài)與介質(zhì)層的質(zhì)量是重要的指標(biāo)。基于 p-GaN 插入層結(jié)構(gòu)的增強(qiáng)型 HEMT 器件��,p-GaN 插入層結(jié)構(gòu)同樣是一種實(shí)現(xiàn) HEMT 器件增強(qiáng)型操作的方案��,這種結(jié)構(gòu)的優(yōu)勢(shì)在于可以排除柵介質(zhì)層對(duì)器件的影響����,而其典型劣勢(shì)源于p-GaN 和下方AlGaN形成的 p-n 結(jié),該 p-n 結(jié)在柵極施加正電壓超過某一閾值時(shí)會(huì)正向開啟����, 進(jìn)而導(dǎo)致柵極電流增加,造成器件失效���。基于 cascode 結(jié)構(gòu)的增強(qiáng)型器件���,級(jí)聯(lián)技術(shù)是實(shí)現(xiàn)增強(qiáng)型操作的一個(gè)重要技術(shù)路線���,其將一個(gè)Si MOS管與一個(gè)耗盡型的GaN基HEMT采用共源共柵的方式連接。器件整體外接的D為 HEMT 的漏極�,外接的S為MOS 管的源極與HEMT的柵極,外接的G為MOS管的柵極�����,MOS管的漏極與 HEMT 的源極相接����。當(dāng)G端施加電壓大于 MOS 管的閾值電壓時(shí),MOS管導(dǎo)通��,其源�����、漏2端產(chǎn)生較大電流����,并且2端的壓降可以忽略。同時(shí)��,這意味著HEMT的源、柵2端電壓也近似相等����,即柵壓為 0 V,耗盡型 HEMT導(dǎo)通�����。因此任何施加在器件D端的電信號(hào)都會(huì)產(chǎn)生一個(gè)電流��,通過由 HEMT與MOS管 串聯(lián)的電路����,器件整體導(dǎo)通����。同理,當(dāng)G 端施加電壓小于 MOS 管的閾值電壓時(shí)���,MOS 管關(guān)斷����,其源���、漏 2 端 產(chǎn)生較大壓降�����,HEMT 的源���、柵 2 端的電壓差同樣明 顯�,HEMT 中的柵壓小于閾值電壓��,且小于0V����,耗盡型 HEMT 關(guān)斷,HEMT與MOS管相串聯(lián)的電路整體 關(guān)斷�。級(jí)聯(lián)技術(shù)的優(yōu)勢(shì)在于其繞過了增強(qiáng)型 HEMT 的 技術(shù)難點(diǎn),采用現(xiàn)階段技術(shù)極為成熟的 Si 基 MOS 管 來實(shí)現(xiàn)增強(qiáng)型操作����。理論上,cascode 晶體管所需的柵 驅(qū)動(dòng)與傳統(tǒng) Si MOS管一致��,簡(jiǎn)化了驅(qū)動(dòng)電路的額外設(shè)計(jì)���。但級(jí)聯(lián)技術(shù)的劣勢(shì)也極其明顯��,它會(huì)增加后續(xù)封裝技術(shù)的復(fù)雜性���;在高溫下��,器件仍然受 Si 管性能 的限制����,GaN 基 HEMT 的優(yōu)勢(shì)難以體現(xiàn)�����。由于 2 種晶體管的特殊連接方式�,會(huì)形成 cascode 器件的內(nèi)部回 路,增加器件內(nèi)部的寄生電感�;由于 Si 管本身的電子遷移率較低�����,級(jí)聯(lián)晶體管很難在高于 1 MHz 的高頻應(yīng)用場(chǎng)景中使用��。其他增強(qiáng)型器件方案���,氟化柵結(jié)構(gòu)的增強(qiáng)型 HEMT 的特點(diǎn)在于柵區(qū)勢(shì)壘層中的離子注入���, 一般情況下會(huì)注入氟離子��。除此之外����,VG-HEMT 結(jié)構(gòu)也可以實(shí)現(xiàn) HEMT 器件的增強(qiáng)型操作��,它通過將器件溝道的一部分轉(zhuǎn)化為縱向�,由于縱向部分并無 2DEG,所以器件在柵極零偏壓下處于關(guān)斷狀態(tài)����。END(說明:文字僅限技術(shù)交流,旨在促進(jìn)行業(yè)進(jìn)步����。圖片來自文獻(xiàn)。)參考:黃火林. "GaN 基增強(qiáng)型 HEMT 器件的研究進(jìn)展." 電子與封裝 23(1). (2023)